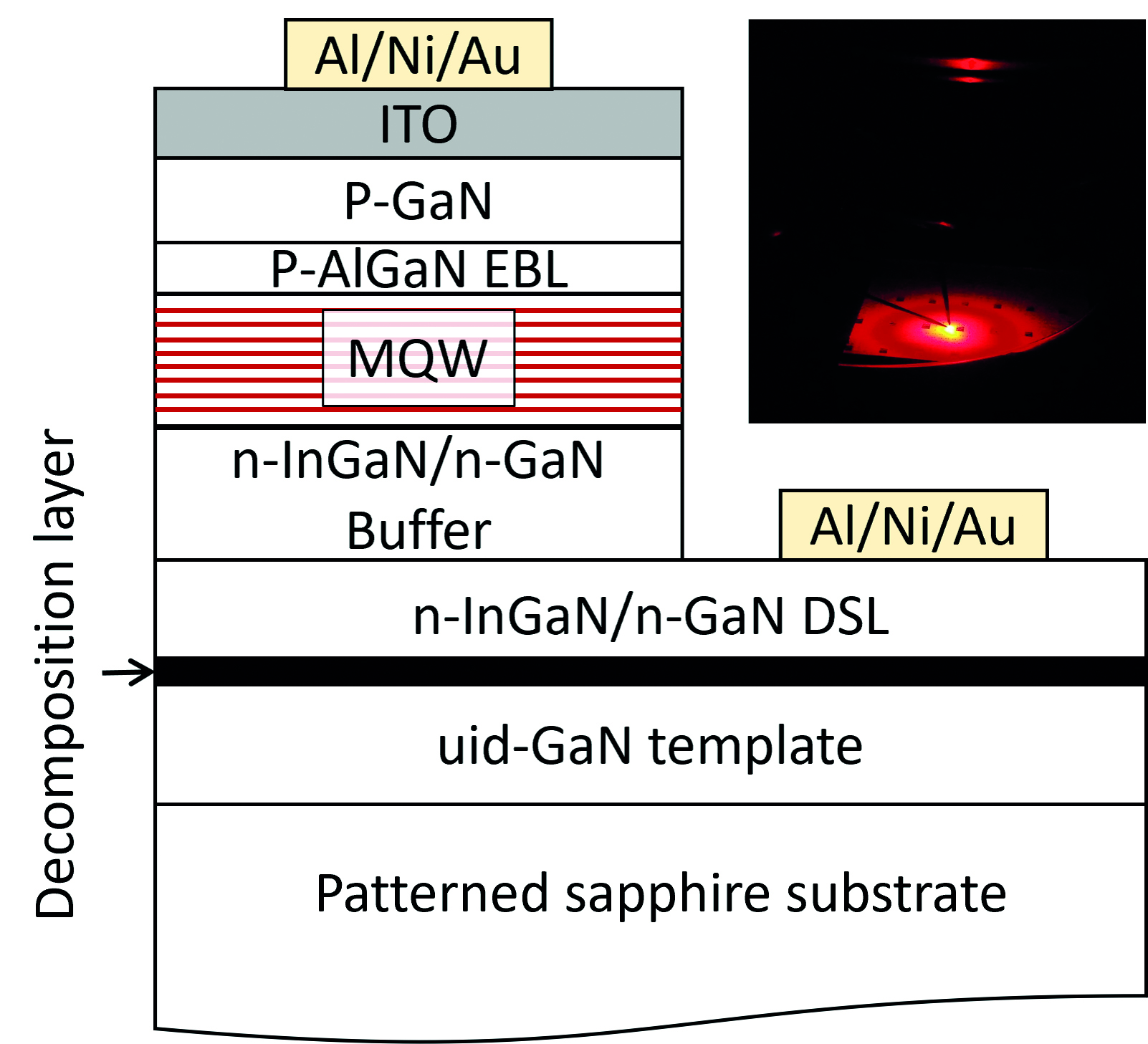
nGaN 层的有意分解为红色发射量子阱的高温生长提供了基础
加州大学圣巴巴拉分校 (UCSB) 的研究人员声称,通过提高用于生长发红光的 InGaN LED 的温度,开辟了新天地。这一突破来自于引入宽松的 InGaN 缓冲器。
西海岸团队的方法不同于常规方法,即在比绿色和蓝色同类产品低得多的温度下生长基于 InGaN 的再发光 LED。虽然在较低温度下生长可以使该光谱域中发射所需的量子阱中的铟含量更高,但它有一个主要缺点:它会抑制原子迁移率,并最终由于缺陷增加而降低效率密度和表面形态的退化。
来自更高生长温度的更高效率的承诺将受到基于 microLED 的显示器开发人员的欢迎。尽管 AlInGaP LED 在尺寸为数百微米或更大时可提供非常高的效率,但由于少数载流子扩散长度较长,因此在缩放时性能会下降。幸运的是,这对于基于氮化物的 LED 来说不是问题,因为它们降低了表面复合速度。
与制造发红光的氮化物 LED 相关的困难之一是 InGaN 和 GaN 之间的大晶格失配。除了诱导错配位错外,这种错配产生的应变通过一种称为成分拉动的机制减少了铟的掺入。
为了对抗这种拉动效应,可以引入松弛的 InGaN 缓冲器,以减少应变并实现更高的生长温度。UCSB 之前的工作已经通过电化学蚀刻形成了这样的缓冲层,该蚀刻使 GaN 底层多孔化。然而,根据最新工作的发言人Philip Chan的说法,这种方法有几个缺点:它需要复杂的处理,它只能确保缓冲区的部分松弛,并导致基板的可用面积大幅减少。
Chan 和同事开发了一种替代方法来实现松弛缓冲,包括 InGaN 层的有意热分解。
该团队的器件制造始于在 720 °C 下生长 3 nm 厚的 InGaN 分解层。随后在该温度下生长 4 nm 厚的 GaN 层,然后将腔室升温至 930 °C 并添加分解停止层,包括五个周期的 18 nm 厚 n 型 InGaN 和 2 nm 厚 n 型氮化镓。在这种高温生长过程中,高铟含量的分解层分解形成空隙,使分解停止层松弛并形成 LED 的模板。在这个松弛的平台上,团队添加了一个松弛的 InGaN 缓冲器,这要归功于兼容的分解层,然后是器件(见图,该图显示了分解层,其中包含在 100 A cm-2 下运行的器件的插图图片)。
晶圆上测试显示,当电流密度从 5 A cm-2 增加到 50 A cm-2 时,LED 的峰值波长会从 770 nm 转移到 660 nm。Chan 将这种偏移的幅度描述为“相当标准”,主要归因于载波的极化场屏蔽。“仔细控制掺杂分布有助于筛选该领域。但是,总的来说,红色 InGaN microLED 的商业可行性仍有待观察。”
另一个问题是光谱峰的宽度。Chan 表示,它的半高全宽为 69 nm,这个值对于显示器来说是不可行的。n 侧的电流传播不佳是部分原因,应该很容易在未来的设备中修复。